总电离剂量效应
方法
总剂量效应是器件辐射效应的一个重要方面。器件暴露在辐射环境中一定时间后,也就是累积了一定剂量后,器件晶体管漏电流可能会增加,阈值可能漂移,亚阈值斜率可能会变化,等等。如果剂量高到一定程度,器件可能失效。
如下图,本方案的总剂量效应的仿真分为 2 步:

- 电离退火仿真:从“剂量分布”到“固定电荷和表面态分布”,是电子、空穴、H$^+$ 离子、H$_2$ 分子等在绝缘体中和界面出的产生、漂移、扩散、捕获、逃逸的过程,作用时间较长(几天到几年),在算法中还需要考虑绝缘体与半导体方程求解的耦合。
- 器件仿真:从“固定电荷和表面态分布”到“漏电流阈值电压漂移”是电子和空穴在半导体电场下的漂移扩散运动,这是三维 TCAD 器件仿真的常规功能。
本仿真方案适用问题举例:
- 计算氧化物中电荷和界面电荷密度
- 分析沉积剂量的影响,电场的影响,以及时间温度等退火条件的影响
- 仿真低剂量率增强效应
算例结果
下图给出仿真结果,图示颜色为受到 500kRad 辐射剂量后的 65nm nMOS 管硅材料中电子浓度(氧化物未被显示)。图中可以看到,由于 STI 侧壁的累积正电荷导致 nMOS 的侧壁和拐角处都有通路产生,即寄生晶体管。其中拐角处通路会导致阈值电压漂移,下侧通路会导致漏电流抬升。如下图虚线箭头所示。
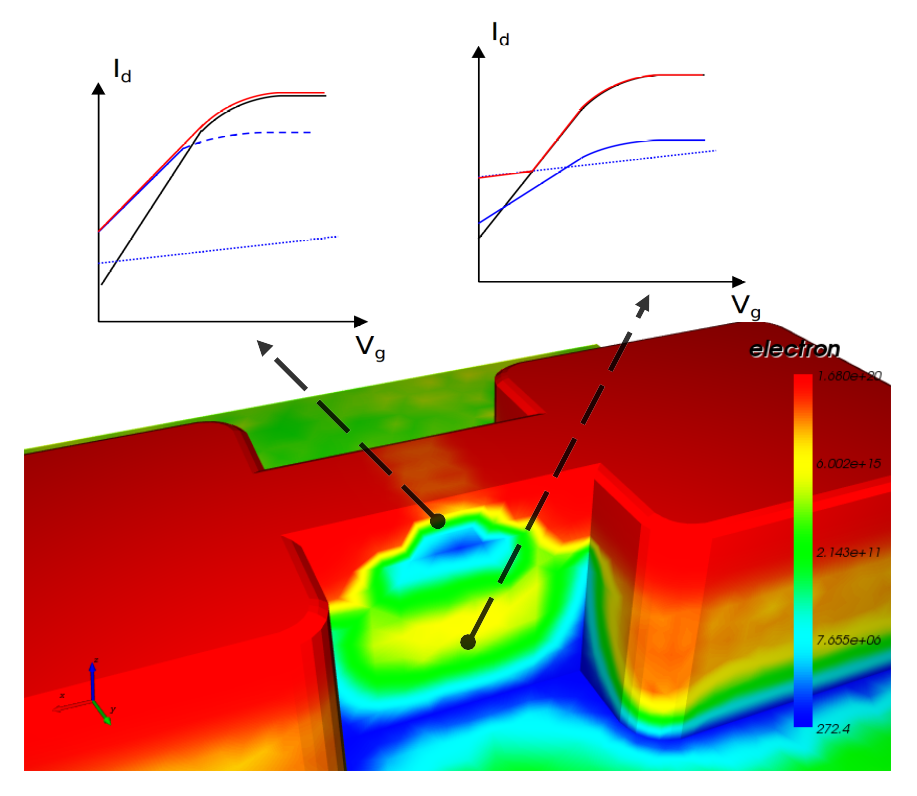
SPICE 模型
基于以上两步仿真,我们对总剂量的机理认知更未清晰,进而提出更为合理的总剂量 SPICE 模型。
加固设计
基于以上物理原理仿真,可以对总剂量效应的机理有丰富深刻的认识。比如,栅的形状对总剂量效应的影响。然后可以尝试各种新的晶体管设计来降低总剂量效应。而这些设计,又可以通过仿真来检查验证。
空间轨道总剂量预估
CRad 软件可以给出在空间某轨道工作一段时间后累积的总剂量-屏蔽厚度曲线。据此曲线可以预估器件在空间的寿命。
 国产EDA技术先驱 | 培风图南半导体
国产EDA技术先驱 | 培风图南半导体

