CMOS 器件的总剂量效应
总剂量效应是器件辐射效应的一个重要方面。器件暴露在辐射环境中一定时间后,也就是累积了一定剂量后,器件晶体管漏电流可能会增加、阈值和亚阈值斜率可能会变化。剂量高到一定程度,器件可能失效。
计算机仿真
计算机仿真能在这个领域所做的工作,取决于对器件受辐射时候的物理和电化学过程的细节上的了解程度。也取决于用什么样的模型方程和参数来描述,和如何用程序实现这些方程。参数的校准对仿真的准确度至关重要,恰当的数值方法对仿真的速度重要。

上图给出计算机仿真总剂量效应的现状。有三个环节:
-
从 radiation(辐射) 到 dose distribution(剂量分布) 是高能粒子传输的领域。现代蒙特卡罗方法可以精确仿真。
-
从 dose distribution(剂量分布) 到 trapped charge distribution(空间电荷和表面态) 是电子、空穴、H+ 离子、H2 分子等在绝缘体中和界面出的产生、漂移、扩散、捕获、逃逸的过程,作用时间较长(几天到几年),因素较多,仿真不容易实现。
-
从 trapped charge distribution(空间电荷和表面态) 到 leakage current increase(漏电流等器件响应)是电子和空穴在半导体电场下的漂移扩散运动,现代 TCAD 器件仿真可以精确做到。
对如上第 2.个环节,人们做了很多努力,并仍然在努力中。
培风图南的工作
仿真
之前出现了两个较为全面的总剂量模型,分别由 N.L. Rowsey (2012) 和 I.S. Esqueda (2011) 提出。每个模型都构建了一套方程来描述绝缘体和界面在剂量作用后的带电或不带电粒子的产生、移动等过程。配合细致校准过的参数,这两个模型都跟实验结果吻合得很好。珂晶达用数值方法实现了这两个模型。其中 Esqueda 2011 模型在 Genius 的新版中发布。

下面三张图给出一个 65nm NMOS 晶体管在接受(从左到右) 100, 300, and 500kRad 总剂量后的电子浓度模拟结果。红色表示多,蓝色表示少。可以看看出,随剂量增加,电子浓度也在变化。这是因为周围的绝缘体中(尤其STI)的空间电荷的增加。
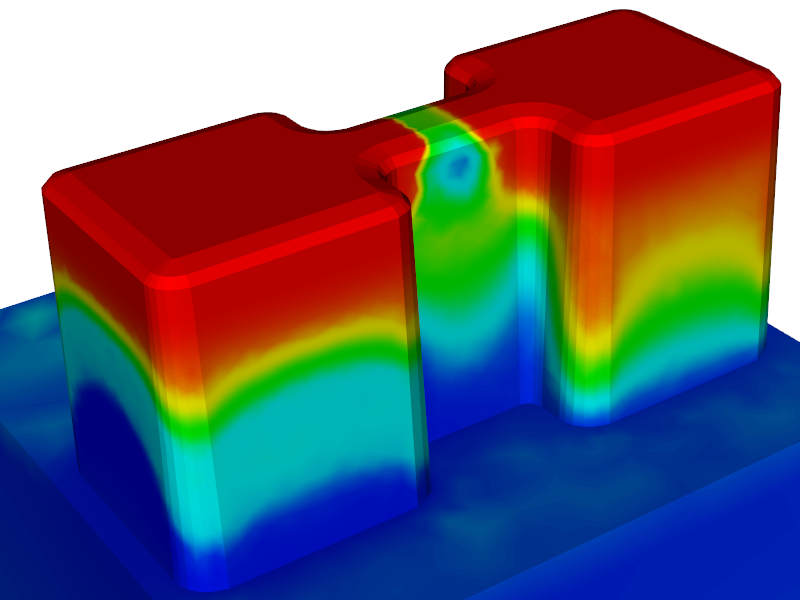
模拟结果图1:一个 65nm NMOS 晶体管在 100, 300, and 500kRad 总剂量下的电子浓度
从上图可以想到,这个晶体管会有漏电流。正如下图所示:
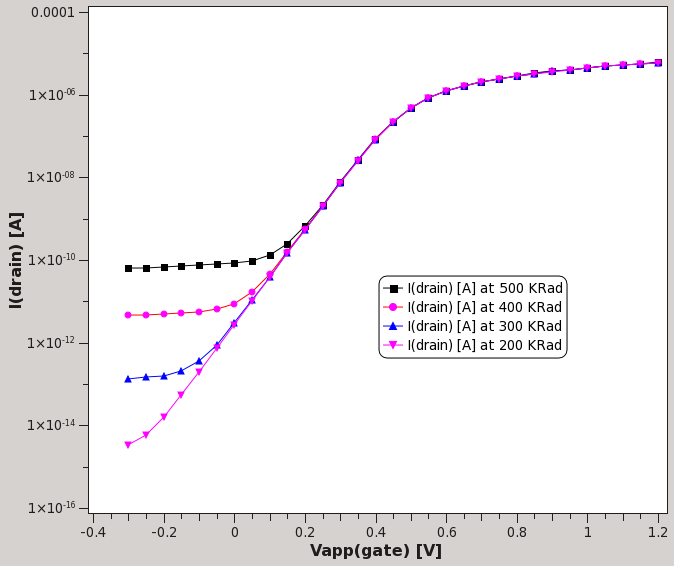
模拟结果图2:不同总剂量下的 Id-Vg 曲线
类似这样的仿真可以协助用户去认识半导体器件在受辐射后的细节。
总剂量效应的 SPICE 模型
用 SPICE 模型来描述总剂量效应,一个方法是用寄生晶体管。下图是一个 130nm NMOS 晶体管在 500kRad 剂量下的电子浓度,并画出了本征晶体管和两个寄生晶体管。
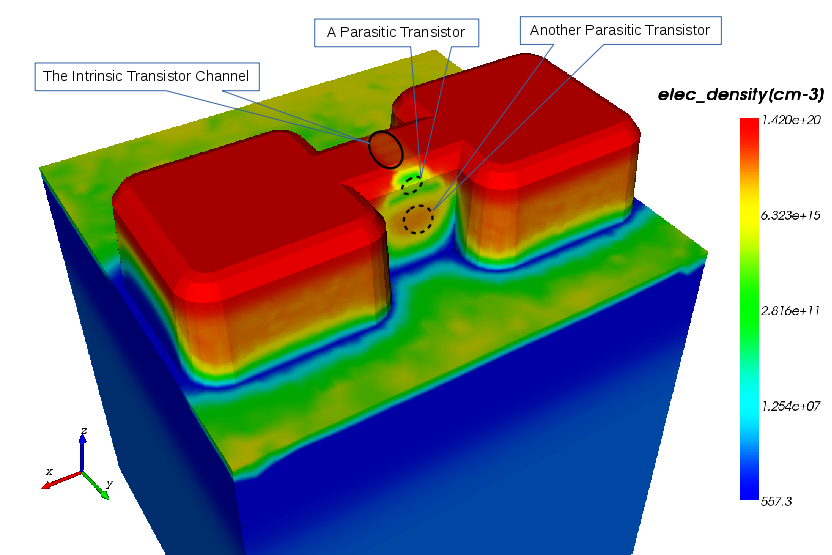
培风图南提供 SPICE 模型相关的服务。
加固设计
- 这样的仿真,也可以协助加固设计,表现在如下方面::
- 对辐射的效果有更细致的了解,比如知道具体在哪里发生了漏电
- 于是可以找到更好的加固方法
- 验证加固方法,用计算机仿真比“流片+实验”要快捷方便
- 对已有的加固方法进行优化,或者应用于新工艺时,也适合用计算机仿真
培风图南也提供加固设计服务。
卫星轨道总剂量预估
培风图南提供软件产品 CRad 来预估卫星轨道的总剂量和其他效应。
- 参考文献
- N. L. Rowsey, Quantitative modeling of total ionizing dose reliability effects in device silicon dioxide layers. 2012.
- I. S. Esqueda, Modeling of total ionizing dose effects in advanced complementary metal-oxide-semiconductor technologies. PhD thesis, Arizona State University, 2011.
 国产EDA技术先驱 | 培风图南半导体
国产EDA技术先驱 | 培风图南半导体

