Lithography modeling and mask synthesis
MoSizen® OPC provides a comprehensive resolution enhancement technology (RET) solution, encompassing a range of standardized technical modules, including rapid calculation of image intensity, rule-based and model-based mask correction, post-OPC verification, and sub-resolution assist feature insertion. This solution is designed to elevate photolithography precision and improve yield, ensuring a robust and reliable manufacturing process.
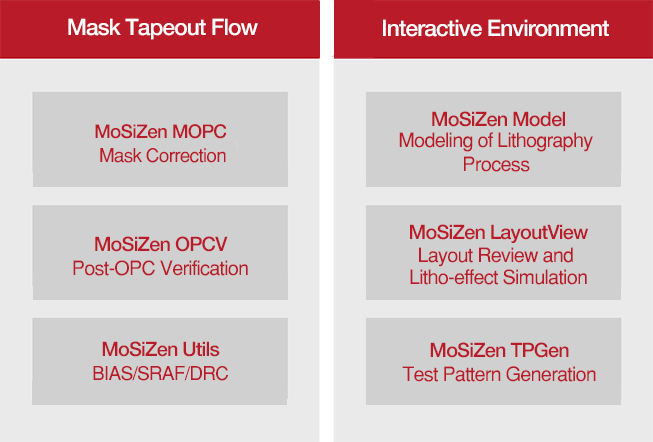
Modeling
-
Optical Model
- Rapid calculation of aerial image
- Rapid TCC(Transmission Cross Coefficient)
- The physical superposition effects of the light source and pupil on the mask patterns
- 3D mask
-
Resist Model
- A rich set of mathematical models
- Full coverage of diffusion and other chemical reactions
- Overfitting prevention
-
Comprehensive optimization
- Efficient fitting computation module
- Multi-parameter, multi-strategy optimization
- Support for process window modeling workflow
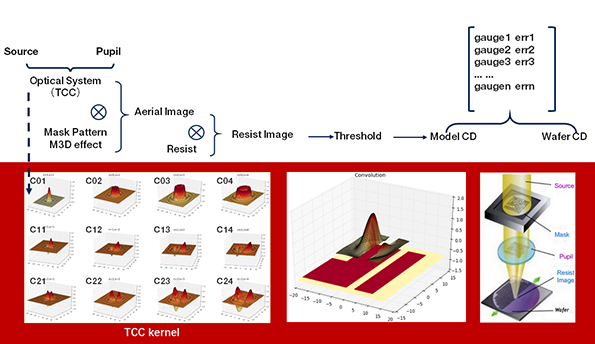
Mask Process
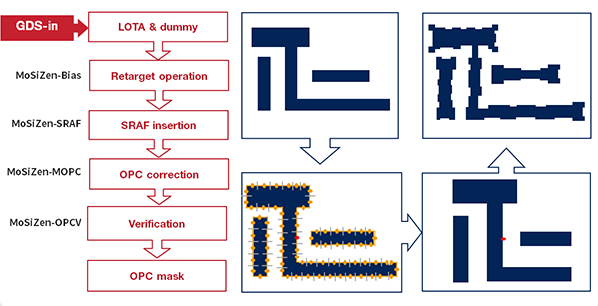
-
BIAS
- Rule-based mask distortion
- Driven by pre-determined OPC rules
- Support for rules in both tabular and itemized formats
-
SRAF
- Generate sub resolution assistance feature
- Rule-based sub-resolution assist feature insertion tool
- Flexible and diverse rules for cleanup
-
MBOPC
- Model-based mask correction
- Possess a flexible and comprehensive set of fragmentation rules
- Fragment movement based on image intensity
- Complete and flexible mask rule constraints(MRC)
-
OPCV
- A simulator for lithography and tool for verifying OPC results
- Pinch, bridge and edge displacement error(EPE) check
- Perform calculations for mask error enhancement factor(MEEF), image log-slope(ILS), normalized image log-slope (NILS) and process window(PW)
- esults classification
 Domestic EDA technology pioneer | PFTN semiconductor
Domestic EDA technology pioneer | PFTN semiconductor

